产品信息
特点 ●可在紫外和可见(250至800nm)波长区域中测量椭圆参数 ●可分析纳米级多层薄膜的厚度 ●可以通过超过400ch的多通道光谱快速测量Ellipso光谱 ●通过可变反射角测量,可详细分析薄膜 ●通过创建光学常数数据库和追加菜单注册功能,增强操作便利性 ●通过层膜贴合分析的光学常数测量可控制膜厚度/膜质量
测量项目 测量椭圆参数(TANψ,COSΔ) 光学常数(n:折射率,k:消光系数)分析 薄膜厚度分析
用途 半导体晶圆
栅氧化膜,氮化膜
SiO2,SixOy,SiN,SiON,SiNx,Al2O3,SiNxOy,poly-Si,ZnSe,BPSG,TiN
光学常数(波长色散) 复合半导体
AlxGa(1-x)多层膜、非晶硅 FPD
取向膜
等离子显示器用ITO、MgO等 各种新材料
DLC(类金刚石碳)、超导薄膜、磁头薄膜 光学薄膜
TiO2,SiO2多层膜、防反射膜、反射膜 光刻领域
g线(436nm)、h线(405nm)、i线(365nm)和KrF(248nm)等波长的n、k评估 原理 包括s波和p波的线性偏振光入射到样品上,对于反射光的椭圆偏振光进行测量。s波和p波的位相和振幅独立变化,可以得出比线性偏振光中两种偏光的变换参数,即p波和S波的反射率的比tanψ相位差Δ。
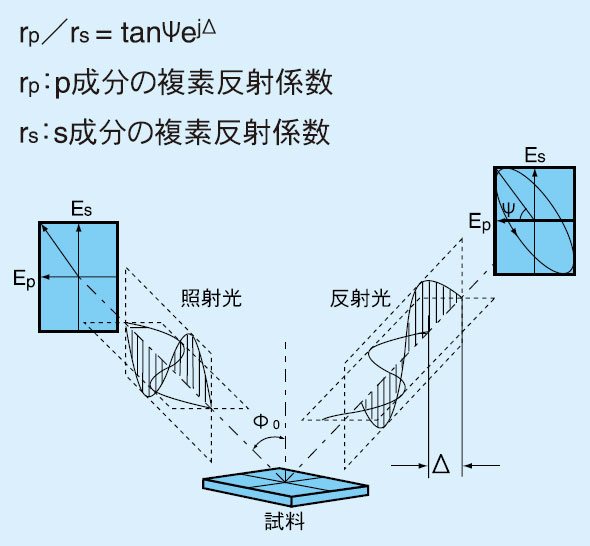 产品规格 | 型号 | FE-5000S | FE-5000 |
|---|
| 测量样品 | 反射测量样品 |
|---|
| 样品尺寸 | 100x100毫米 | 200x200毫米 |
|---|
| 测量方法 | 旋转分析仪方法*1 |
|---|
| 测量膜厚范围(ND) | 0.1纳米- |
|---|
| 入射(反射)的角度范围 | 45至90° | 45至90° |
|---|
| 入射(反射)的角度驱动方式 | 自动标志杆驱动方法 |
|---|
| 入射点直径*2 | 关于φ2.0 | 关于φ1.2sup*3 |
|---|
| tanψ测量精度 | ±0.01以下 |
|---|
| cosΔ测量精度 | ±0.01以下 |
|---|
| 薄膜厚度的可重复性 | 0.01%以下*4 |
|---|
| 测定波长范围*5 | 300至800纳米 | 250至800纳米 |
|---|
| 光谱检测器 | 多色仪(PDA,CCD) |
|---|
| 测量用光源 | 高稳定性氙灯*6 |
|---|
| 平台驱动方式 | 手动 | 手动/自动 |
|---|
| 装载机兼容 | 不可 | 可 |
|---|
| 尺寸,重量 | 650(W)×400(D)×560(H)mm
约50公斤 | 1300(W)×900(D)×1750(H)mm
约350公斤*7 |
|---|
| 软件 |
|---|
| 分析 | 最小二乘薄膜分析(折射率模型函数,Cauchy色散方程模型方程,nk-Cauchy色散模型分析等)
理论方程分析(体表面nk分析,角度依赖同时分析) |
|---|
*1可以驱动偏振器,可以分离不感带有效的位相板。
*2取决于短轴?角度。
*3对应微小点(可选)
*4它是使用VLSI标准SiO2膜(100nm)时的值。
*5可以在此波长范围内进行选择。
*6光源因测量波长而异。
*7选择自动平台时的值。
|